
2013年01月14日11:17 來源:人民網-財經頻道
2012年,採用TSV(硅通孔)的三維封裝技術繼2011年之后再次成為半導體封裝業界備受關注的焦點。
1月,JEDEC固態技術協會(JEDEC Solid State Technology Association)發布了以TSV為前提的移動DRAM新標准“JESD229 Wide I/O Single Data Rate”(SDR)。基於TSV的三維封裝作為能以低功耗及大帶寬連接智能手機及平板電腦用SoC(應用處理器)和DRAM的技術而備受期待。今后,如果供貨量很大的便攜終端能夠採用基於TSV的三維封裝技術,就有望加快TSV的低成本化步伐。
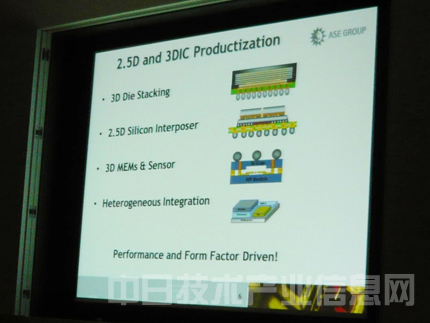
三維封裝技術是“ICEP-IAAC 2012”的重要議題
在2月舉行的“ISSCC 2012”上,美國IBM公司介紹了通過採用基於TSV的三維封裝技術,來層疊連接高性能微處理器和緩存的事例。盡管很多情況下都會在微處理器上層疊存儲器,但在高性能用途方面,如何為微處理器散熱是一大課題。因此,IBM採用了在存儲器上層疊微處理器的構造。而且IBM還在開發通過提高層疊芯片之間的密封樹脂的導熱率,來提高散熱性的技術。
在4月舉行的半導體封裝技術國際會議“ICEP-IAAC 2012”上,三維封裝技術同樣成為了一項重要議題。目前,在三維封裝技術的業務化方面,最佳供應鏈模式尚不明確,后工序代工廠商(OSAT)台灣日月光集團提出了多種業務模式,稱“大家都在探索最佳解決方法”。
而世界第一大代工企業台積電公司(TSMC)則提出了從晶圓制造到封裝組裝全部由台積電一家公司負責的總承包模式。通過採用名為“CoWoS(Chip on Wafer on Substrate)”的自主制造技術,可提高組裝時的成品率。
不過,這種總承包模式是否會成為今后三維封裝技術的主流,目前尚不明確。台積電的競爭對手——美國GLOBALFOUNDRIES公司目前並未大力推介總承包模式,而是十分重視與OSAT等的合作。
關於利用TSV硅轉接板的2.5維封裝技術,以高端FPGA為主的量產化正在不斷推進之中。繼28nm工藝之后,20nm以上工藝也與微細化一樣被定位於實現大規模化、高集成化的核心技術。
在“摩爾法則”正在接近極限的形勢下,估計基於TSV的三維封裝技術會對今后推進芯片的高性能化、低功耗化起到更加重要的作用。(日經技術在線! 供稿)
