
2014年06月05日09:01
【新闻链接】
“这是终极有机EL技术”――荧光材料实现与磷光同等的发光效率
转接板插在半导体芯片和封装基板之间使用,作用在半导体芯片的微细图案与封装基板的稀疏图案之间进行引脚间距转换。以前硅和玻璃一直被视为转接板的有力材料,而现在又出现了有机材料这个新选择。
在2014年的电子元件与技术会议(ECTC)上,由于对半导体元件进行三维层叠并布线的3D技术为时尚早,因此,有关在半导体元件和封装基板之间插入转接板的2.5D技术的论文发表比较多。而且,因为玻璃材料的研发也告一段落,所以有关玻璃转接板的演讲十分引人注目。在这种情况下,日本新光电气工业发布的有机转接板技术因极具独创性而备受关注。
新光电气工业将其开发的有机转接板命名为“i-THOP(Integrated Thin film High density Organic Package)”。虽说是转接板,其实采用了在普通增层式(Build-up)基板上层叠微细布线层的构造。其特点如下(图1)。
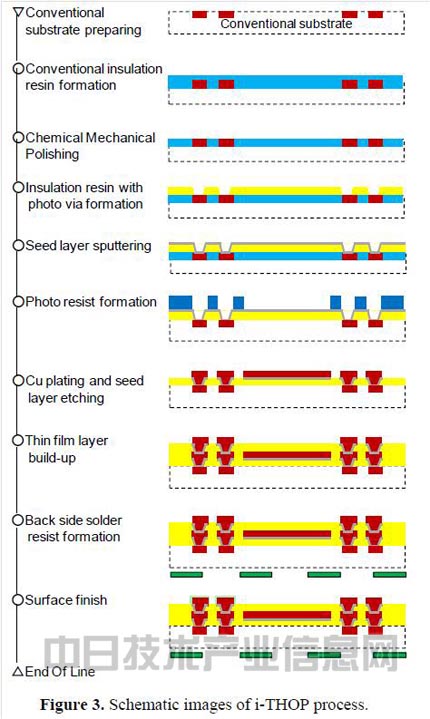
(1)以增层式基板(1/2/2基板)为基础,在其表层以增层方式形成了微细布线层;(2)作为基础的增层式基板利用CMP(化学机械研磨)技术将表面粗糙度降低到了Ra=20nm;(3)微细布线层采用旋涂技术涂敷光敏性液状树脂,形成了3μm厚的绝缘层;(4)感光孔径为10μm,分别布线宽度和最小间距均为2μm;(5)倒装芯片Pad直径为25μm,Pad间距为40μm;(6)形成布线时,先通过Ti/Cu溅射工艺形成晶种层,然后再进行电解镀铜;(7)采用OSP(有机可焊性保护层)或ENEPIG(化镍钯浸金)技术进行布线表面处理。
i-THOP在封装组装工序中可作为普通基板使用,不需要像硅转接板或玻璃转接板那样在封装基板上层叠转接板。倒装芯片焊接工艺方面,使用OSP时,需要涂敷焊剂并加热,使之气化后再进行热压焊接。使用ENEPIG时,无需涂敷焊剂即可进行热压焊。而先涂敷底部填充树脂再进行倒装芯片焊接的技术,因接合不够充分,容易发生通孔裂缝,因此不建议采用。
试制品将两个半导体芯片挨在一起焊在i-THOP上,采用毛细管型底部填充(Capillary Underfill)技术封装(图2)。新光电气工业还对试制品的热翘曲进行了评测,室温下的翘曲为30μm左右,而在回焊温度下基本是平的。(作者:中岛 宏文,日经技术在线!供稿)

